- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 辐射研究与辐射工艺学报[10/30]
《炬丰科技-半导体工艺》PR-Mask氧化硅湿蚀刻工艺
作者:网站采编关键词:
摘要:书籍:《炬丰科技-半导体工艺》 文章:PR-Mask氧化硅湿蚀刻工艺中枝晶状缺陷的去除方法 编号:JFKJ-21-966 作者:炬丰科技? 引言 我们观察到半导体制造过程中光刻胶掩模氧化硅湿法刻蚀
书籍:《炬丰科技-半导体工艺》
文章:PR-Mask氧化硅湿蚀刻工艺中枝晶状缺陷的去除方法
编号:JFKJ-21-966
作者:炬丰科技?
引言
我们观察到半导体制造过程中光刻胶掩模氧化硅湿法刻蚀过程中形成新的树枝状缺陷(DLD)。树突是分枝状晶体,表现出显示晶体方向性的形态特征,如直的初生茎、次生侧臂,甚至第三纪分枝。当非多面材料从过冷熔体或过饱和溶液中生长时,通常会观察到树枝状晶体,其特征是光滑的抛物线状尖端和尖端后面的侧枝。通过许多分析和实验,现已认识到表面张力和/或原子附着动力学中的各向异性对于稳定尖端区域防止尖端分裂起着重要作用。?
大多数关于微电子器件制造过程中枝晶形成的报道主要与金属腐蚀反应有关,因为在微电子器件阴极/阳极结构的腐蚀反应过程中,溶解的金属离子如铝、银或铜的减少会导致金属枝晶的成核和生长。然而,关于半导体加工中湿法刻蚀过程中枝晶形成的报道非常有限。在本文中,我们指出了在半导体制造过程中PR掩模氧化硅湿法刻蚀后检测到的一种新型枝晶状缺陷(DLD)及其去除方法。
?
实验
?
图1a展示了一个典型的带有PR掩模的氧化物湿法刻蚀工艺,其中单元阵列中的氧化物隔离层被稀释HF (dHF)的湿法化学腐蚀,而核心/外围区域中的氧化物隔离层被KrF PR图案(b)阻挡。在使用具有单晶片清洁剂的足够的湿蚀刻剂去除氧化物隔离物后,300毫米晶片被用去离子水冲洗(DIW)并通过以高转速连续旋转干燥(c)。对旋转干燥过程后的缺陷位置进行监测,并对DLD进行仔细检查。
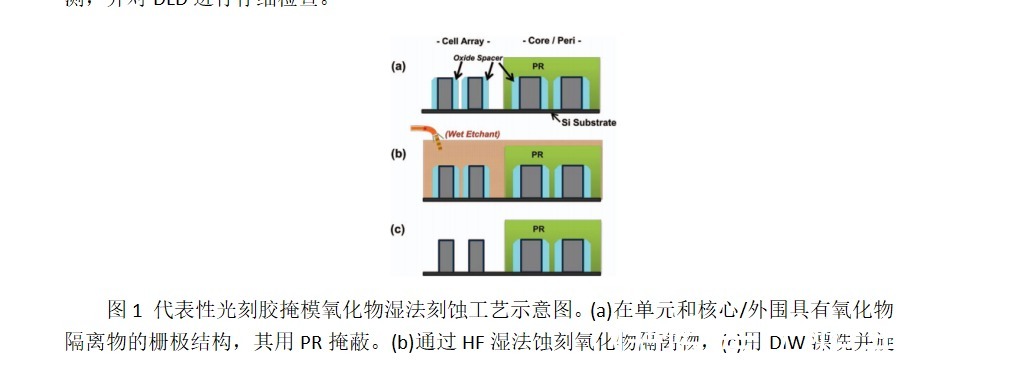
结果和讨论
?
在连续的氧化物湿法蚀刻、DIW漂洗和旋转干燥之后,在核心/周边区域的PR掩蔽表面上检测到的DLD的各种形状和大小如图2所示。缺陷尺寸从几十纳米到几十微米变化很大,大多数类金刚石薄膜整体呈圆形,像水痕一样,具有高度多分支的树状结构,而部分缺陷的形貌为致密形状,没有分形生长。原则上,高度支化的枝晶可能在远离平衡的条件下产生,其中反应物质的扩散是速率限制的,而致密枝晶可能在表面动力学重要且接近平衡条件时产生。这种尺寸和形状的多样性意味着控制枝晶生长和形态的驱动力,例如过饱和程度、反应物质向晶体表面的扩散以及表面和界面能量在晶体表面上是不均匀的晶片的整个表面。这可归因于旋转干燥期间角速度的不均匀性、光刻胶的表面粗糙度和湿蚀刻速率随时间的变化。
图3b,这是典型DLD的高放大扫描电镜图像3a 表明DLD是由两种不同的成分组成的。这种形态特征在小的非分枝DLD的扫描电镜图像上清晰可见(图3c),呈现出一种核壳混合结构。在电子显微镜分析过程中,当强电子束辐射到特定区域时,大部分缺陷被分解和/或升华;然而,尽管电子束辐射时间更长,支撑结构的框架仍然存在。这一结果表明DLD可能是一种有机/无机杂化复合材料,因为无机盐如碱金属或碱土金属卤化物很容易被电子束辐射分解。
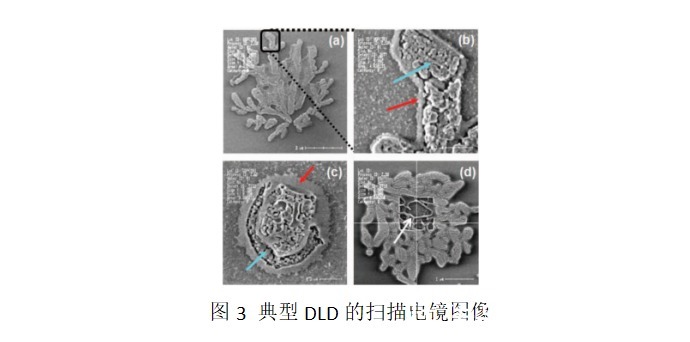
氟硅酸盐纳米晶体可以通过蒸发驱动结晶形成,更复杂的纳米结构如纳米板或纳米线/纳米棒也可以通过随后的结晶融合和过饱和过程中的自组装结晶生成。然而,据推测,经典的晶体生长模型不适合DLD形成,因为有机成分在形成和生长中起着重要作用,在该模型中,稳定的核通过单位细胞复制而简单地扩大,而不会引起体或表面的结构变化。
?
DLD形成的机制如图2所示5。如图2所示1PR-掩模氧化物湿法蚀刻工艺分为三个步骤:(a)湿法蚀刻,(b)用DIW漂洗,和(c)用高转速旋转干燥。
?
一旦PR表面形成DLD,应用传统的晶圆清洗工艺,如增加DIW清洗时间、SC1清洗和过氧化氢/ DIW混合物(H2O2/H2O)清洗,很难完全去除。在我们的研究中,发现两种方法对消除DLD病是有效的。第一种方法包括在湿法刻蚀工艺之前对光刻胶表面进行氧等离子体处理。一般估计两种等离子体处理效果;首先,聚合物表面的氧等离子体处理改变了表面组成,并通过极性基团的形成使聚合物表面趋向于高度亲水,导致表面润湿性的改善。其次,通过调节等离子体条件,光刻胶显影后的有机残留物可以重新移动,在光刻胶表面形成硬壳层。
结果表明,等离子体处理有效地消除了光刻胶表面的残留物,提高了表面粗糙度。由于PR表面的等离子体处理效应阻碍了带有相反电荷有机分子的氟硅酸盐纳米晶的聚集介导生长,因此难以生成DLDs。通过使用全晶圆缺陷检测工具,确认了DLD形成的最终状态。去除DLD的第二种方法是在最后的清洗步骤中引入臭氧化去离子水(O3/DIW)。由于其对有机污染物的高效去除,臭氧水处理能够在室温下短时间内有效去除DLD水中的有机成分。一旦有机骨架的去除开始,氟硅酸盐聚集物或纳米晶体本身可以通过简单的DIW清洗过程容易地去除。因此,几乎相同的缺陷检查图与图6d 在最后的湿蚀刻过程中臭氧化水处理后观察到。H2SO4/H2O2混合物也通常用于再移动有机化合物,例如等离子体蚀刻过程中产生的PR和聚合物。然而,它甚至可以攻击公共关系掩模图案几秒钟,因为H2SO4/H2O2混合物通常以高温(120℃)和非常浓缩的形式(h2so 4∶h2so 4的2∶1至4∶1)使用。因此,在光刻胶掩模氧化物湿法蚀刻工艺中,它不适合DLD的迁移。
文章来源:《辐射研究与辐射工艺学报》 网址: http://www.fsyjyfsgyxb.cn/zonghexinwen/2021/1109/1187.html