- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 辐射研究与辐射工艺学报[10/30]
《炬丰科技-半导体工艺》 α-羟基酸湿法刻蚀In
作者:网站采编关键词:
摘要:书籍:《炬丰科技-半导体工艺》 文章:α-羟基酸湿法刻蚀InP 编号:JFKJ-21-1180 作者:华林科纳 ? 引言 InP半导体的可控蚀刻和表面钝化对于去除受损表面和获得良好的电子性能是理想的
书籍:《炬丰科技-半导体工艺》
文章:α-羟基酸湿法刻蚀InP
编号:JFKJ-21-1180
作者:华林科纳
?
引言
InP半导体的可控蚀刻和表面钝化对于去除受损表面和获得良好的电子性能是理想的。我们观察到,与仅基于无机酸的蚀刻相比,有机酸(α-羟基酸:酒石酸、乳酸、柠檬酸和苹果酸)与盐酸一起用于蚀刻磷化铟的表面时,会产生更光滑和无缺陷的表面。有机酸的螯合作用有助于有效地从表面去除铟,这导致非常可控的蚀刻。?
为了在磷化铟加工层/衬底的顶部生长半导体层,通常必须回蚀很小厚度的磷化铟,以去除加工过程中受损的表面层和表面杂质。因此,需要具有非常低且可控的蚀刻速率的蚀刻溶液,这为表面提供了光滑的镜面光洁度。有人建议使用盐酸和α-羟基酸(乳酸、柠檬酸、苹果酸和酒石酸)的含水混合物来蚀刻磷化铟。可以看到这些酸与ⅲ-ⅴ族半导体中的ⅲ族离子强烈结合;它们的螯合性质结合了磷化铟的铟原子,使表面蚀刻反应更加均匀。因此,避免了盐酸蚀刻导致的优先磷耗尽。
?
实验
采用的一般策略是仔细研究在水溶液中用盐酸和不同比例的羟基酸蚀刻磷化铟表面。虽然磷化铟的快速蚀刻已经有了很好的记录,但是在获得非常慢、可控和可再现的蚀刻方面的工作要少得多。本研究表明,使用乳酸、苹果酸、柠檬酸和酒石酸会导致磷化铟蚀刻非常缓慢和均匀。 蚀刻实验采用半绝缘InP(100)晶片和ingas/InP双异质结构晶片,用于蚀刻研究的样品在三氯乙烯(TCE)、丙酮、异丙醇和去离子水中各超声清洗3分钟,每次清洗之间用干燥氮气吹干。
?
讨论和结果
盐酸本身就以一种蚀刻率猛烈地攻击InP。单独在水介质中使用盐酸不适合缓慢可控蚀刻(5nm/min),因为表面相当粗糙,图2a这里的蚀刻是选择性的,并导致指向45°的蚀刻坑。其蚀刻机理主要涉及In和P的溶解,蚀刻坑表面可以是一种。在传统的蚀刻处理中,添加了10种磷酸(磷酸),可能是为了减缓磷的优先蚀刻。然而,这种处理导致蚀刻凹坑的圆化,并没有改善表面外观,图b搅拌溶液会产生更小的蚀刻坑和粗糙的表面,然而,由于InP的盐酸蚀刻受到动力学控制,蚀刻速率没有改变。
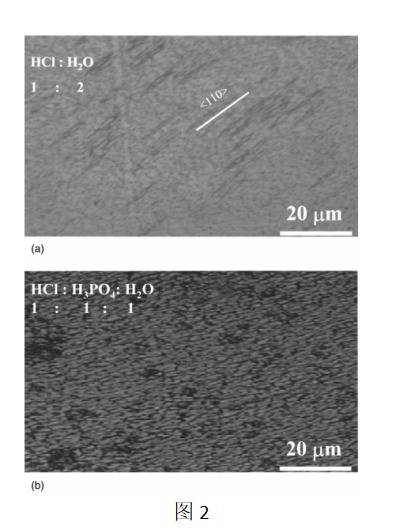
当a-羟基酸加入盐酸水溶液时,最显著的影响是表面变得非常光滑,由于稀释作用,蚀刻速率较慢,但也取决于所使用的特定酸。稀释效应可能归因于盐酸离子解离的增加,因此in-p键的氧化分子盐酸较少。图4b提供了与不含有机酸的盐酸水混合物的比较;无论稀释程度如何,InP表面都总是粗糙的。我们还发现,搅拌HCl:H2O:有机酸混合物并没有改变蚀刻速率,这说明蚀刻机理仍受到反应速率的控制。
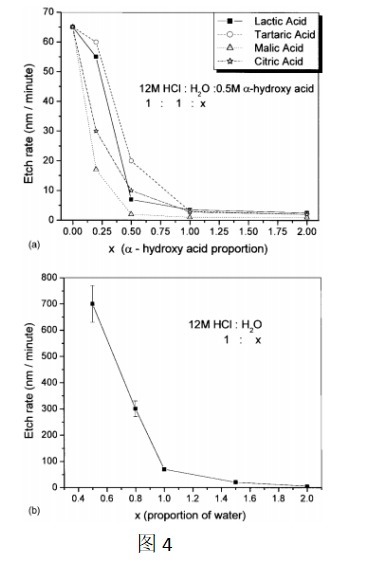
我们定义了一个参数,蚀刻各向异性,为下切深度与蚀刻深度之比,这对于不同的晶体面是不同的,酸的相对蚀刻速率为酒石酸、乳酸酸、苹果酸、柠檬酸。。
从以上的例子中可以看出,有机分子可以作为蚀刻反应的辅助手段。已经证明,a-羟基酸可以与盐酸一起用于控制蚀刻。这里提出的化学蚀刻可以用于去除由于辐射和器件处理而损坏的表层,并为随后的再生做好准备。在我们的模型中,有机酸有助于形成内-羟基酸配合物~螯合物,这导致同时去除In和P,导致不优先蚀刻。uCOOH和uOH基团的数量和位置决定了相对反应速率,从这个角度来看,乳酸和酒石酸最良性,而柠檬酸和苹果酸的反应性更强。酒石酸和乳酸的蚀刻各向异性最低,但切口最小。研究a-羟基酸对不同InP平面的影响是很有趣的。
文章来源:《辐射研究与辐射工艺学报》 网址: http://www.fsyjyfsgyxb.cn/zonghexinwen/2021/1215/1273.html