- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 辐射研究与辐射工艺学报[10/30]
《炬丰科技-半导体工艺》EUV掩膜表面清洁对光刻(2)
作者:网站采编关键词:
摘要:图2显示了所有三种情况下40纳米和36纳米光盘的等焦光盘匹配LER曲线。 当比较两个图中的三条曲线时,通过焦点看不到太多变化。在比较所有这些指标时,
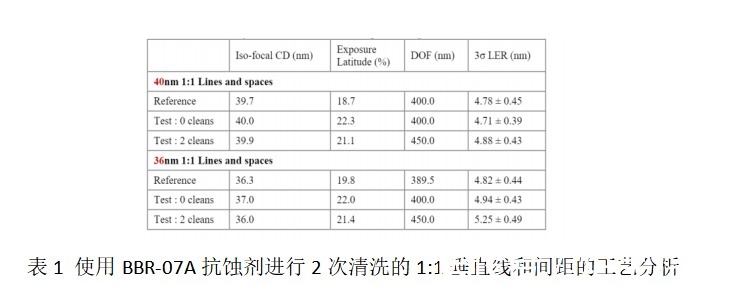
图2显示了所有三种情况下40纳米和36纳米光盘的等焦光盘匹配LER曲线。
当比较两个图中的三条曲线时,通过焦点看不到太多变化。在比较所有这些指标时,我们可 以有把握地假设,经过两次清洗后,没有对掩模表面或图案造成足以导致工艺变化的影响。?
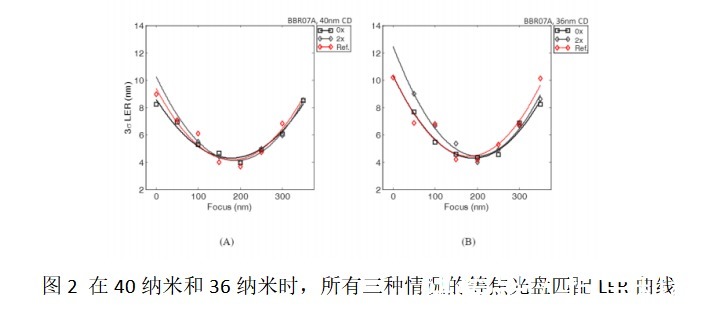
在所有情况下,在10%的CD变化下,曝光宽容度的绝对变化小于5%。这属于微曝光工具图案化的工艺稳定性,支持了当前观察到的数据差异不是清洁结果的结论。我们还注意到,参考掩模显示出比清洁掩模更多的工艺变化,进一步支持了我们的结论。
?
总结
?
许多研究先前已经表明,掩模清洗通过引起LER增加和工艺宽容度降低而对钉覆盖层有害。为了获得可接受的EUVL掩模寿命,需要识别能够去除污染物同时保持掩模表面质量的清洁工艺。对于这项研究,使用一种被发现能有效去除掩模表面污染物的清洁方法来重复清洁未被污染的掩模表面。跟踪表面和成像性能变化的系统评估。这里报告了基于原子力显微镜的表面分析结果和光盘工艺分析结果。到目前为止,评估的表面分析数据没有给出任何值得关注的原因。对于图案化,两种不同的MET基线抗蚀剂用于环形照明。 .
总结的数据并未表明晶片间工艺误差超出预期的变化。这就得出了一个显而易见的结论,清洁确实有效,清洁后的口罩性能与新口罩相当。
文章来源:《辐射研究与辐射工艺学报》 网址: http://www.fsyjyfsgyxb.cn/zonghexinwen/2021/1104/1180.html