- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 《辐射研究与辐射工艺学[10/30]
- · 辐射研究与辐射工艺学报[10/30]
《炬丰科技-半导体工艺》KOH蚀刻对镓面极性n-G
作者:网站采编关键词:
摘要:书籍:《炬丰科技-半导体工艺》 文章:KOH蚀刻对镓面极性n-GaN表面性质的影响 编号:JFKJ-21-829 作者:炬丰科技 ? ? ? 关键词:表面性能,接触力学,电学性能,氮化镓,金属化 ? 摘要
书籍:《炬丰科技-半导体工艺》
文章:KOH蚀刻对镓面极性n-GaN表面性质的影响
编号:JFKJ-21-829
作者:炬丰科技
?
?
?
关键词:表面性能,接触力学,电学性能,氮化镓,金属化
?
摘要
通过x射线光电子能谱、原子力显微镜、反射高能电子衍射、电流电压和电子束诱导电流表征,研究了氢氧化钾处理对n型氮化镓表面性质和相关Au/n-GaN接触点的影响。比较了分子束外延和金属有机化学气相沉积生长的气体极性表面。氢氧化钾处理后,Au/n-GaN接触的非辐射重组特性增加,与表面Ga空位增加、表面N-H2含量增加和表面C污染减少有关。对于分子束外延生长的氮化镓,Ga3d峰位置的0.3eV转移和位错对比的减少,这表明表面Ga空位和线程位错在定义合成的金属/GaN接触特性方面只发挥了有限的作用。因此,在评价n-GaN表面的电学性质和相关的金属接触点的性能时,应考虑到氢氧化钾处理后的表面原子含量和由此产生的表面状态。
?
介绍
?基于砷化镓的器件的性能受到用于连接到电源或其他器件的金属触点的质量的显著影响。金属/n-GaN接触点的电学性能取决于各种各样的处理参数,如氮化镓表面的清洗和蚀刻,金属接触层的组成和厚度,以及用于激活接触点的退火温度和大气。由于增强的扩散偶联金属化层和退火条件已经被确定以提高接触性能,因此也越来越注意金属化前氮化镓表面的制备。 需要详细的研究来评估所采用的化学处理、氮化镓表面由此产生的化学/结构修饰与接触点的电学性能之间的密切关系。
本研究通过研究氢氧化钾蚀刻对n-GaN表面性质和相关的Au/n-GaN肖特基接触的影响,来研究确定势垒高度的机制。
?
实验
?采用氮化镓射线光电子能谱(XPS),使用AlKαx射线在10kV和阳极发射电流20mA下,评估蚀刻氮化镓样品的表面化学性质。样品在最后的盐酸清洗阶段后立即装入XPS室。利用原子力显微镜(AFM)维维原子力显微镜研究了表面形态。样品的近表面晶体结构是通过反射高能电子衍射(RHEED)进行评估,这是在改进的Jeol2000fx透射电子显微镜(TEM)中进行的,使用垂直安装在投影仪透镜下方的样品表面的斜角衍射。为了进行互补电流-电压(I-V)测量和电子波束诱导电流(EBIC)调查,样本集使用相邻区域从相同的晶圆。玻璃阴影掩模被用来定义金肖特基接触,以及用于地面连接。在4x10-6Torr的室压力下使用热蒸发器,以3nm/s至125nm的厚度同时沉积在所有样品上。在的腔室压力下,使用电子束蒸发器沉积在0.7nm/s,厚度为200nm。EBIC测量使用Jeol6400扫描电子显微镜(SEM)在10kV的加速电压下工作和MatelectIV5低噪声电流放大器进行。
?
结果
n-GaN?表面的表征:图2a,b显示了参考hcl清洗的MBE和MOCVD氮化镓样品的1x1μmAFM高度振幅图像。mbe生长的样品的表面形态(图。2a)明显比MOCVD样品更粗糙(图2b),rms值分别为15.0nm和0.62nm。图2a的形态表明了这种mbe生长的GaN/蓝宝石样品的精细细胞颗粒结构,而MOCVD生长的GaN/蓝宝石样品通常表现出更大的粒度晶体结构,螺纹位错含量明显较低。因此,图2b显示了一个更平滑的阶梯流表面,偶尔观察到梯田终止于被认为是包含螺钉组件的螺纹位错的特征。结果发现,氢氧化钾处理对MBE表面略有改变。图3显示了一个1x1μm的AFM高度氢氧化钾蚀刻MBE样品的振幅图像,显示了平底六角形凹坑的发展,密度为,平均深度为40nm。样品的均方根粗糙度降低了1.8nm。相反,氢氧化钾处理在AFM的检测范围内并没有改变MOCVD表面的形态。
金/氮化镓接触点的表征: 利用二次电子(SE)和EBIC操作模式,通过扫描电镜进一步研究了金接触样品的性能。在SE模式下获得的地形对比度图像(图。6a,b)分别表明MBE-和MOCVD-生长的氮化镓样品表面粗糙和光滑,再次与AFM图像一致。EBIC测量评估这些样品的电活性是在相对较低的10kV加速电压下进行的,试图强调接触的氮化镓表面对EBIC信号的贡献。EBIC图像拍摄自与SE图像相同的区域显示,MBE生长的氮化镓样品中有一个~350nm大小的小亚粒密度较高(图。MOCVD生长的氮化镓样品的~1μm尺寸亚粒(图6d),再次与MBE和MOCVD生长的GaN/蓝宝石异质结构的不同微观结构一致。对于mbe生长的氮化镓样本,低EBIC信号的位置似乎与相关的SE图像中的晶界位置相关。然而,在EBIC实验的分辨率范围内,生成的非放射性重组活性的图像没有提供由于氢氧化钾处理的效果而造成的额外特征。
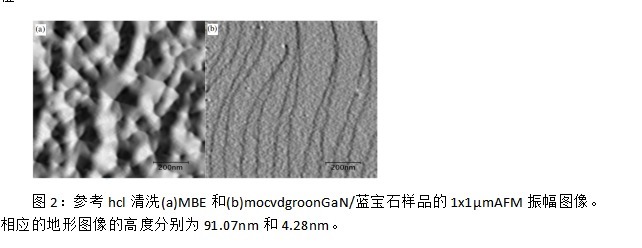

文章来源:《辐射研究与辐射工艺学报》 网址: http://www.fsyjyfsgyxb.cn/zonghexinwen/2021/1014/1133.html